半導體材料迭代與騰盛切割探索方向
發布時間:2022-08-09 08:41:37 瀏覽:68次 責任編輯:騰盛精密

隨著電子產品向小型化趨勢發展,對芯片性能和體積的要求越來越高。在半導體發展過程中,新興材料出現,芯片表面的薄化及平坦化處理在整個芯片加工過程中顯得愈發重要。高精度的切割、研磨工藝對有效控制產品破損率、提高芯片良率有著極大幫助。新興材料的出現會帶來了哪些機遇? 半導體切割工藝在未來會有怎樣的發展趨勢?
一、半導體材料概述
半導體材料作為半導體產業鏈上游的重要環節,在芯片的生產制造過程中起到關鍵性作用。根據芯片制造過程劃分,半導體材料主要分為基體材料、制造材料和封裝材料。
?基本材料:硅晶圓片、化合物半導體
?制造材料:電子特氣、濺射靶材、光刻膠、拋光材料、掩膜版、濕電子化學品
?封裝材料:芯片粘結材料、鍵合絲、陶瓷封裝材料、引線框架、封裝基板、切割材料

化合物半導體材料的演進情況
第一代半導體材料是以硅(Si)、鍺(Ge)為主,第二代半導體材料是以砷化鎵(GaAs)、銻化銦(lnSb)為主。以碳化硅(SiC)、氮化鎵(GaN)、氧化鋅(ZnO)、金剛石、氮化鋁(AIN)為代表的寬禁帶半導體材料,被稱為第三代半導體材料,目前發展較為成熟的是碳化硅(SiC)和氮化鎵(GaN)。

與傳統材料相比,第三代半導體材料更適合制造耐高溫、耐高壓、耐大電流的高頻大功率器件。近些年,SiC和GaN市場火熱,關注度極高。憑借先天優勢,SiC和GaN確實有良好的發展前景,特別是在高功率應用方面,會是將來的主流。不過,就整個化合物半導體應用市場而言,無論是當下,還是可預見的未來,以GaAs為代表的第二代化合物半導體仍是市場的主導力量。因為與硅相比,GaAs最大的優勢在于工作溫度高(最高可以到攝氏350度左右)、耐熱、抗輻射、發光效率也很高,基于這樣的特性,GaAs主要用于三個領域:射頻(RF),約占47%,發光二極管(LED ),約占42%、激光二極管(LD),約占10%。5G時代,GaAs仍將主導智能手機PA(射頻功率放大器)市場。
總之,從當下和未來化合物半導體市場總量來看,GaAs和InP依然占據絕大部分,而SiC和GaN則會在高功率應用領域逐步擴大占有率。
新的第三代半導體材料行業是我國重點鼓勵發展的產業,是支撐經濟社會發展和保障國家安全的戰略性和基礎性產業。為加快推進第三代半導體材料行業的發展,國家層面先后印發《重點新材料首批次應用示范指導目錄(2019版)》、《國務院關于印發進一步鼓勵軟件產業和集成電路產業發展若干政策的通知》等鼓勵性、支持性政策;而地方層面也積極響應,通過政策將實質性的人、
財、物資源注入,推動著各地半導體材料產業的集聚和發展。

半導體材料細分形成三大梯隊
政策扶持、市場需求、資本進入、技術迭代是中國半導體材料產業快速發展、市場規模持續擴大的主要推力。目前,中國半導體材料對于進口產品的依賴程度仍然較高,而且根據細分產品競爭力和國產化進度,由強到弱可以將中國半導體材料產業分為三大梯隊。不同材料產業進入壁壘、中國企業進入時間階段和參差不齊的技術積累是使得半導體材料形成三大梯隊的主要原因。

當前半導體材料國產化進度參差不齊∶其中拋光材料、濺射靶材、引線框架等已經達到世界一流水平;電子特種氣體、掩膜板等材料產品已進入量產,技術上已向世界領先水平看齊;光刻膠等材料仍處于向領先技術學習的階段,雖已實現階段性的技術突破,但還未能實現大規模量產,量產是下一步發展目標。
縱觀整個半導體材料領域,由于其技術壁壘高、生產難度大、驗證周期長等特點,導致大部分半導體材料都處于寡頭壟斷的局面,核心技術長期掌握在歐美、日本、德國、韓國等國家手中。
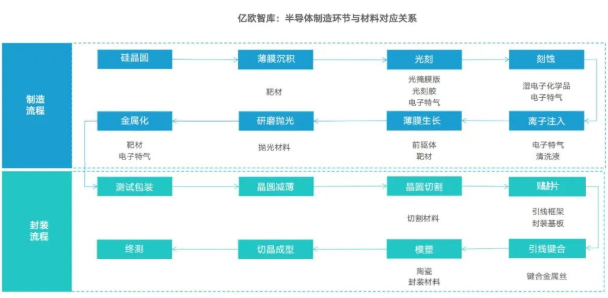
其中,日本就供應了全球超50%的半導體材料,例如全球超70%的光刻膠均由日本生產,由JSR、東京應化、信越化學、富士電子4家企業瓜分。而在半導體制造過程所需的19種核心材料中,日本就占到了14種,處于絕對領先地位。此外在硅片市場,2018年全球近90%的市場都被日本、中國 、德國、韓國占據,市場集中度非常高。
相比之下,我國本土半導體材料行業起步晚、發展慢,加之本土市場長期被國外巨頭牢牢占據,導致本土企業呈現“小而散”的格局。不過,隨著國產替代浪潮的推動,如今越來越多的本土企業開始切入半導體材料領域,大大推動了國產半導體行業技術自主性的發展。
二、緊跟材料更迭步伐,深耕工藝
隨著化合物半導體的多樣化發展,材料有很多新的變化,對切割時使用的工具和切割過程的控制而言都是新的挑戰。
切割、劃片其實是半導體產業中的一個細枝分節點,但我們遇到的半導體材料幾乎都需要切割,不管是用激光切割、刀片切割,還是用裂片的方式,總要經過這一道工序。 比如,以前 PCB,Wafer的切割可能只需要一把硬刀或一把軟刀就能應對。但現在越來越多的Wafer會加入玻璃、銅等材料,還有WLCSP封裝,molding之后的封裝,和以前相比,現在的材料對切割和研磨的要求十分高。挑戰很大,但也潛藏著新的機遇。 在材料的發展過程中,如果廠家的工藝、技術迭代跟不上,就會丟失大量的客戶,一部分跟不上新材料更迭的廠家會被淘汰。
Tensun騰盛高精密半導體切割系統經韓國專家團隊精心研制多年,且經過行業知名客戶驗證與日本同行對比性能、功能完全可與之媲美的高精密半導體刀片式切割系統,可應用于半導體晶片、LED晶片 & EMC導線架、 PCB、 IR/濾光片、藍寶石玻璃、 陶瓷薄板等材料的精密切割。目前,騰盛精密也已成為行業內第一家推出無膜切割兼容貼膜切割的廠商。
在Wafer Saw切割工藝領域中,考慮到間距發展越來越小,未來可能會向玻璃基或其他材料更加穩定的方向發展,因此,騰盛精密的設備集中在切邊方面,保證芯片到下一個基板之間拼接的間隙。以全自動切割系統ADS2100為例,該機臺采用創新布局方案,每個料盒可以存放20-25層料片,自動上料、位置校準、切割、清洗/干燥、下料均可由本系統自動完成,切割性能以150微米厚度bumping晶圓為例,正面崩邊低于5微米,背面崩邊低于7微米,側面深度符合預設值標準,切割道偏移量低于2微米,可以滿足8~12寸材料的高精密切割加工,該機臺還可雙主軸同時切割,比單主軸切割產能提高85%以上,高低倍雙定位識別影像系統 ,適用多材料加工,并實時監測系統的氣壓、水壓、電流等數值,避免主軸損傷。

8-12寸雙軸精密全自動劃片機ADS2100
同時在基板劃片領域,騰盛精密研發出中國第一臺雙工位自動切割&分選一體機,也實現了兩大工序合一,可大大提升封測廠商生產效率。

未來,中國半導體材料行業挑戰與機遇并存。人們對于新材料的應用有著巨大的憧憬,隨著工藝技術的成熟,在未來,我們也期待更多新材料能夠廣泛用于人們的生活,更多讓人新奇、驚喜的新興應用走進我們生活。TENSUN騰盛精密也將繼續深耕技術工藝,打造符合時代進步的半導體切割系統,助力推動國內半導體技術的發展,和廣大半導體相關企業共同建設穩定的半導體行業產業鏈,維持中國半導體行業的可持續發展。

————
聲明:本文部分內容參考出處有:
1.「中國半導體制造及封裝材料行業報告」,來源:億歐智庫
2.「化合物半導體制造格局生變」,作者:暢秋
如有侵權等行為,可聯系我方刪除。
 深圳市騰盛精密裝備股份有限公司
深圳市騰盛精密裝備股份有限公司